- p - n-ПЕРЕХОД
- p - n-ПЕРЕХОД
-
- (электронно-дырочный переход) - слой с пониженной электропроводностью, образующийся на границе полупроводниковых областей с электронной (n -область) и дырочной ( р -область) проводимостью. Различают гомопереход, получающийся в результате изменяющегося в пространстве легирования донорной и акцепторной примесями одного и того же полупроводника (напр., Si), и гетеропереход, в к-ром р-область и n- область принадлежат разл. полупроводникам. Термин " р - п.-П." как правило, применяют к гомопереходам.
Обеднённый слой. Из-за большого градиентаконцентрации электронов ( п )и (обратного ему по знаку) градиентаконцентрации дырок ( р )в р - n -П. происходит диффузионноеперетекание электронов из п -об-ласти в р -область и дырокв обратном направлении. Его следствием является накопление избыточногоположит. заряда в n -области и отрицательного - в р -области(рис. 1). При этом появляется электрич. поле, направленное из n -областив р -область, действие к-рого на электроны и дырки (при термодинамич. <равновесии) компенсирует действие градиентов концентрации, т. е. диффузионныепотоки электронов и дырок уравновешиваются дрейфовыми потоками во внутреннемэлектрич. поле Е вн перехода. Поле Е вн обусловливаетдиффузионную разность потенциалов V Д (аналог контактнойразности потенциалов), величина к-рой (для невырожденных носителей)в р- и n -областях выражается ф-лой
Здесь е - заряд электрона, Т- темп-pa полупроводника, ni - концентрация электроновв собств. полупроводнике, п п и р р - концентрацииэлектронов и дырок в п- и р -областях. Внутр. электрпч. полесосредоточено в обеднённом (запорном) слое р - n- П., где концентрацииносителей обоих типов меньше концентраций основных носителей в р -и n -областях вдали от перехода ( п<п п, р< р р),а мин. уровень суммарной концентрации электронов и дырок достигает значения( п+ р) мин= 2ni. Т. к. в обеднённомслое, как правило, разность концентрации свободных носителей мала по сравнениюс разностью концентраций ионизиров. доноров (N д) и акцепторов(Na), границы этого слоя с квазинейтральными р -и n -областями wp и wn могут бытьнайдены (после приближённого интегрирования Пуассона уравнения водномерном случае) из ф-л

где e- диэлектрпч. проницаемость полупроводника.
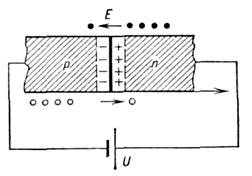
Рис. 1. Схематическое изображение р- n -перехода; чёрные кружки - электроны, светлые - дырки.
Т. к. Ферми уровень
 во всём полупроводнике при термодинамич. равновесии должен быть единым, <то в области перехода энергетич. зоны полупроводника изгибаются (рис. 2),так что образуется потенциальный барьер, высота к-рого равна V д.
во всём полупроводнике при термодинамич. равновесии должен быть единым, <то в области перехода энергетич. зоны полупроводника изгибаются (рис. 2),так что образуется потенциальный барьер, высота к-рого равна V д.
Внеш. напряжение U, приложенноек р - n -П., в зависимости от знака уменьшает (прямое смещение, <плюсы соответствуют р -области) или увеличивает (обратное смещение)напряжённость электрич. поля в обеднённом слое, сужая или расширяя егопри этом. Зависимость положения границ слоя wn, wp, от смещения U может быть найдена из ф-л (2),
где следует заменить V Д на V Д - U (U.<0 - при обратном). В случае резкого сильно асимметричного р +- п -П. (Na N Д )с т. н. металлургич. границей (на к-рой N Д- Na =0) x0=0 и однородно легированной n -областью(N д = const):
N Д )с т. н. металлургич. границей (на к-рой N Д- Na =0) x0=0 и однородно легированной n -областью(N д = const):
В случае плавного р - п -П. <с пост. градиентом разности концентрацией доноров и акцепторов (N д- Na = ах, а =const):


Рис. 2. Зонная диаграмма (н) и концентрацииэлектронов и дырок ( б) в области р - п -перехода;
 - дно зоны проводимости,
- дно зоны проводимости, - вершина валентной зоны;
- вершина валентной зоны; - уровень Ферми.
- уровень Ферми.Определяемая толщиной обеднённого слоя w(U)= |wn(U) - wp(U)| зарядная ёмкость С3 р - п -П. уменьшается с ростом обратного смещенияно закону С3~ (|U| + V Д)-1/2 в случае ф-лы (3) (для резкого перехода) и С з~ (| U|+V Д)1/3 - в случае ф-лы (4) (для плавного перехода).При увеличении прямого смещения зарядная ёмкость растёт. Измерение зависимости C3(U )позволяет исследовать изменение разности N д(x) - Na(x )в р- п -П.
Ток через р - п- П . Свключением внеш. напряжения U дрейфовые потоки перестают компенсироватьдиффузионные потоки и через р - п -П. течёт электрич. ток. Т. к. <в глубине р -области ток переносится дырками, а в n -области- электронами, то прохождение тока через р - n -П. - в прямом направлении(U р - п -П. из областей, где они являются основными носителямизаряда. При U< О ток обусловлен генерацией электронно-дырочныхпар в окрестности р - п -П., к-рый разделяет их движение от р - п-П. <в области, где они являются основными носителями.
При термодинамич. равновесии термич. генерацияносителей в каждой точке образца в точности компенсируется их рекомбинацией. <Но при прохождении тока этот баланс нарушается. Существует неск. механизмов(каналов) избыточной генерации и рекомбинации, определяющих проводимость р - п -П. при прямом и обратном смещениях. а) Генерация ирекомбинация носителей в р- и n -областях и диффузия носителейк р- n -П. или от него. В единице объёма n -полупроводникав единицу времени рождается вследствие равновесной термич. генерации дырок, где р п - равновесная концентрация дырок в п -областп
дырок, где р п - равновесная концентрация дырок в п -областп 
 а
а  - ихвремя жизни относительно процесса рекомбинации. Все дырки, рождённые вслое с толщиной L р, прилегающем к р - п -П.,уходят в р -область, т. к. внутр. поле р - п -П. "втягивает"туда все дырки, подошедшие к переходу в результате диффузии из п -области;Lp- длина диффузии дырок в n -области за время их жизни:
- ихвремя жизни относительно процесса рекомбинации. Все дырки, рождённые вслое с толщиной L р, прилегающем к р - п -П.,уходят в р -область, т. к. внутр. поле р - п -П. "втягивает"туда все дырки, подошедшие к переходу в результате диффузии из п -области;Lp- длина диффузии дырок в n -области за время их жизни: Dp- коэф. диффузии дырок. Дырки, рождённые вне слоя Lp,рекомбинируют прежде, чем процесс диффузии доставит их к р - n -П.,и не дают вклада в ток. Поэтому плотность тока дырок, уходящих из п -областив р -область:
Dp- коэф. диффузии дырок. Дырки, рождённые вне слоя Lp,рекомбинируют прежде, чем процесс диффузии доставит их к р - n -П.,и не дают вклада в ток. Поэтому плотность тока дырок, уходящих из п -областив р -область:
Аналогично плотность тока электронов, термическирождённых в р -области и доставленных диффузионно к втягивающемуих р - n -П.:

Здесь
 - их равновесная концентрация в р -области, Dn,
- их равновесная концентрация в р -области, Dn, Ln - коэф. диффузии, время жизни, длина диффузии в этойобласти
Ln - коэф. диффузии, время жизни, длина диффузии в этойобласти 
Если бы токам jns и jps не противостояли бы обратные противотоки, то через р- n -П. <проходил бы ток насыщения плотностью js = jns+ jps. Однако в отсутствие виеш. смещения токи неосновныхносителей jns и jps полностью компенсируютсятоками основных носителей (электронов из n -области и дырок из р -области),идущими в обратную сторону и равными, следовательно, также jns и j рs. Основные носители - дырки, переходящие из р -областив n -область, и электроны, идущие из n -области в р -область, <преодолевают на своём пути потенциальный барьер высотой V д и являются по своей природе термоэлектронной (термодырочной) эмиссией черезэтот барьер. Поэтому понижение барьера на величину U при прямомсмещении приводит к увеличению каждого из этих токов в exp(eU/kT )раз(см. Термоэлектронная эмиссия )и не вызывает изменения токов неосновныхносителей (для к-рых барьера нет). С учётом этого обстоятельства плотностьполного тока через р - п -П. можно выразить т. н. ф-лой Шокли (рис.3):

Рис. 3. Вольт-амперная характеристика (ВАХ)v - п- перехода.
При U <0 и e|U|/kT
 1токами термоэмиссии основных носителей через повышенный обратным смещениембарьер (высотой V д + |U| )можно пренебречь и считать, <что плотность обратного тока обусловлена только термогенерац. токами неосновныхносителей: j = - js (рис. 4, кривая 3). При UeU/kT
1токами термоэмиссии основных носителей через повышенный обратным смещениембарьер (высотой V д + |U| )можно пренебречь и считать, <что плотность обратного тока обусловлена только термогенерац. токами неосновныхносителей: j = - js (рис. 4, кривая 3). При UeU/kT 1,наоборот, в ф-ле (7) можно сохранить только экспоненциальный член, описывающийтермоэмиссию носителей из областей, где они являются основными, в области, <где они становятся неосновными и где рекомбииируют за времена
1,наоборот, в ф-ле (7) можно сохранить только экспоненциальный член, описывающийтермоэмиссию носителей из областей, где они являются основными, в области, <где они становятся неосновными и где рекомбииируют за времена  и
и  на расстояниях Lp и Ln. Прямой ток, согласно (7), быстро растёт с ростом U. При значит. смещениях этот рост ограничивается сопротивлением р- и n -областей. Последнее уменьшается благодаря инжекциинеосновных носителей р - n -П. Из сравнения ф-л (5) и (6) видно, <что гл. вклад в ток насыщения обычно даёт слаболегиров. сторона р -п -П. с более низкой концентрацией основных носителей.
на расстояниях Lp и Ln. Прямой ток, согласно (7), быстро растёт с ростом U. При значит. смещениях этот рост ограничивается сопротивлением р- и n -областей. Последнее уменьшается благодаря инжекциинеосновных носителей р - n -П. Из сравнения ф-л (5) и (6) видно, <что гл. вклад в ток насыщения обычно даёт слаболегиров. сторона р -п -П. с более низкой концентрацией основных носителей.
Рис. 4. Обратные токи р - п- перехода;1- тон термогенерации в квазинейтральных областях;2 - тонтермогенерации в обеднённом слое; 3 - ток туннельной генерации;4 - полный ток в отсутствие фотогенерации; 5 - - фототок j ф;6 - полный ток с учётом фототока.
б) Генерация и рекомбинация в обеднённыхслоях (механизм Шокли - Са-Нойса). Рекомбииационно-генерац. ток, описываемыйф-лой (7), не всегда доминирует. В широкозонных полупроводниках (с большойзапрещённой зоной
 )при относительно низких теми-pax может преобладать термич. генерация ирекомбинация в самом обеднённом слое, а не в слоях с толщинами L п и L р. Хотя в таком полупроводнике, как кремний, Ln и Lp обычно сильно превосходят ширину обеднённогослоя w(U), но скорость генерации и рекомбинации там можетбыть существенно выше, чем в квазинейтральных областях, из-за различияв заполнении примесных уровней электронами, ответственными за рекомбинацию. <В этом случае при достаточно больших обратных смещениях (eU/kT
)при относительно низких теми-pax может преобладать термич. генерация ирекомбинация в самом обеднённом слое, а не в слоях с толщинами L п и L р. Хотя в таком полупроводнике, как кремний, Ln и Lp обычно сильно превосходят ширину обеднённогослоя w(U), но скорость генерации и рекомбинации там можетбыть существенно выше, чем в квазинейтральных областях, из-за различияв заполнении примесных уровней электронами, ответственными за рекомбинацию. <В этом случае при достаточно больших обратных смещениях (eU/kT 1)справедлива ф-ла
1)справедлива ф-ла 
где
 - время жизни неравновесных носителей в обеднённом слое, отличное в общемслучае от
- время жизни неравновесных носителей в обеднённом слое, отличное в общемслучае от  и
и  Ток jw можетпревышать js за счёт того, что п i превышает п р и р п. Ток jw ненасыщается с ростом обратного смещения, а растёт по мере расширения обеднённогослоя [напр., в соответствии с ф-лами (3) и (4), рис. 4, кривая 2].
Ток jw можетпревышать js за счёт того, что п i превышает п р и р п. Ток jw ненасыщается с ростом обратного смещения, а растёт по мере расширения обеднённогослоя [напр., в соответствии с ф-лами (3) и (4), рис. 4, кривая 2].В прямом направлении ток, обусловленныйрекомбинацией в обеднённом слое:

Здесь
 причём длина l Е по порядку величины равна "сжатой" длинедиффузии носителей против внутр. поля Е вн: l~kT/eE. Коэф. 2 в знаменателе показателя экспоненты связан с тем, что носители, <рекомбинирующие внутри обеднённого слоя, преодолевают не весь барьер, обусловленныйполем в нём, а только его часть, высота к-рой с приложением внеш. напряжения U уменьшается на U/2. Из-за этого с ростом U ток поф-ле (9) растёт медленнее, чем ток по ф-ле (7), и даёт ему обогнать себяпри достаточно больших смещениях.
причём длина l Е по порядку величины равна "сжатой" длинедиффузии носителей против внутр. поля Е вн: l~kT/eE. Коэф. 2 в знаменателе показателя экспоненты связан с тем, что носители, <рекомбинирующие внутри обеднённого слоя, преодолевают не весь барьер, обусловленныйполем в нём, а только его часть, высота к-рой с приложением внеш. напряжения U уменьшается на U/2. Из-за этого с ростом U ток поф-ле (9) растёт медленнее, чем ток по ф-ле (7), и даёт ему обогнать себяпри достаточно больших смещениях.
в) Межзонное (зинеровское) туннелированне. <Ток электронов через запрещённую зону полупроводника отсутствует толькопри классич. описании движения электронов проводимости и дырок в электрич. <поле. Оно становится недостаточным с ростом напряжённости поля. Из-за туннелированияэлектронов сквозь запрещённую зону (эффект Зинера) тормозящийся в электрич. <поле электрон проводимости, отразившись от дна зоны проводимости имеет вероятность (тем большую, чем круче наклонены зоны) перейти в валентнуюзону (рис. 5, а). При одинаковых эффективных массах электронаи дырки вероятность туннелирования в однородном электрич. поле близка квероятности туннелирования сквозь треугольный барьер, высота к-рого равнаширине запрещённой зоны
имеет вероятность (тем большую, чем круче наклонены зоны) перейти в валентнуюзону (рис. 5, а). При одинаковых эффективных массах электронаи дырки вероятность туннелирования в однородном электрич. поле близка квероятности туннелирования сквозь треугольный барьер, высота к-рого равнаширине запрещённой зоны  а толщина
а толщина  тем меньше, чем больше напряжённость поля Е.
тем меньше, чем больше напряжённость поля Е.
Для реализации туннельного перехода необходимоналичие в валентной зоне дырок. Поэтому туннельный переход является туннельнойрекомбинацией электрона из зоны проводимости с дыркой из валентной зоны. <Такой рекомбинац. процесс не связан ни с передачей энергии колебаниям решётки(т. е. с её нагревом), ни с излучением света: энергия передаётся источникуэлектрич. поля. Обратный процесс - рождение электронно-дырочной пары засчёт энергии электрич. поля (туннельная или зинеровская генерация) - вусловиях термодинамич. равновесия уравновешивает рекомбинацию. Оба этипроцесса в р - п- П . при U =0 имеют место лишь в случае, <когда электронный газ в n -области и дырочный газ в р -областивырождены (рис. 5,б). Прямое смещение ведёт к преобладанию туннельнойрекомбинации, а обратное смещение - к туннельной генерации. Туннельнаясоставляющая тока такого перехода доминирует над прочими только тогда, <когда он предельно резкий. Резкий р - п - П. с вырожденным газомносителей по обе стороны лежит в основе туннельного диода, имеющегона прямой ветви вдоль вольт-амперной характеристики падающий участок N -типа(ВАХ, рис. 5, в).
В случае невырожденных п- и р -областейтуннельный ток может преобладать только при достаточно больших обратныхсмещениях и связан только с туннельной генерацией электронно-дырочных пар. <Ввиду экспоненциальной зависимости туннельного тока от напряжённости электрич. <поля вклад в него даёт лишь окрестность точки макс. поля. По мере ростаобратного напряжения туннельный ток, незаметный на фоне термогенерационногопри низких напряжениях, стремительно нарастает и становится преобладающим(рис. 4, кривая 3).
В широкозонных полупроводниках нарядус термогенерационными и туннельными токами наблюдают их различные комбинации. <С одной стороны, имеет место сочетание туннельных (горизонтальных) переходовмежду зонами и уровнями локальных примесных центров с термогенерационными(вертикальными) переходами (рис. 5, г). С др. стороны, возможно туннелирова-ниес поглощением неск. фононов (рис. 5, д).
Рис. 5. Туннельные явления в р - n -переходе; а - межзонное туннелированис; б - зонная диаграмма туннельногодиода; в- прямая ветвь ВАХ туннельного диода (1 - полнаяплотность тока, 2 - нетуннельная составляющая); г- комбинация термического(1 )и туннельного (2 )переходов с участием примесного уровня; д - возможные варианты генерации: 1 - термическая (многофононная);2 - туннельная (бесфононная); 3 - туннелирование с поглощением фононов.
г) Ударная ионизация. Электроны проводимостис энергией, превышающей её порог, могут порождать электронно-дырочные пары, <истратив на это почти всю свою энергию в зоне. Такую же возможность имеюти дырки с надпороговой энергией. Пороги ударной ионизации для электронаи дырки различны (однако во мн. случаях они слегка превышают
 )..Рождение электронно-дырочной пары носителями, ускоренными до необходимыхэнергий в электрич. поле обратно смещённого перехода, ответственно за лавинноеразмножение носителей в р - n -П. и за его лавинный пробой.
)..Рождение электронно-дырочной пары носителями, ускоренными до необходимыхэнергий в электрич. поле обратно смещённого перехода, ответственно за лавинноеразмножение носителей в р - n -П. и за его лавинный пробой.
Обычно процессы ударной ионизации описываютс помощью коэф. и
и  определяемыхкак ср. числа электронно-дырочных пар, генерируемых одним электроном иодной дыркой на единичном пути их дрейфа в электрич. поле Е. Вширокихобеднённых слоях
определяемыхкак ср. числа электронно-дырочных пар, генерируемых одним электроном иодной дыркой на единичном пути их дрейфа в электрич. поле Е. Вширокихобеднённых слоях  ( х)- локальные ф-ции электрич. поля в точке х:
( х)- локальные ф-ции электрич. поля в точке х:
Здесь т =1, 2; коэф. bn, р не зависят от Е, а С п, <р зависят слабо. Из-за сильной зависимости
 от Е в ударную ионизацию, как и в туннельную генерацию, вносит вкладтолько близкая окрестность точки макс. электрич. поля в обеднённом слое.
от Е в ударную ионизацию, как и в туннельную генерацию, вносит вкладтолько близкая окрестность точки макс. электрич. поля в обеднённом слое.
Из-за ударной ионизации обратный ток р- п -П., обусловленный термической или туннельной генерацией, а такжефото генерацией или инжекцией носителей надлежит умножить на коэф.M(U):J1(U) = j(U) M(U). При =
= =
= (приближённо имеющем место во мн. полупроводниках при больших значениях| Е| )величина M(U )перестаёт зависеть от места, где произошлапервичная генерация, и равна
(приближённо имеющем место во мн. полупроводниках при больших значениях| Е| )величина M(U )перестаёт зависеть от места, где произошлапервичная генерация, и равна 
(направление оси х выбрано из р -областив п -область).

Это определяет напряжение U пр лавинного пробоя р - n -П.: стационарный режим с обратным напряжениемна р - n -П. .U пр невозможен. <Для лавинного пробоя важна ударная ионизация обоими типами носителей. Еслив размножении участвуют, напр., одни только электроны, то напряжение U пр
 оо(бесклнечность).
оо(бесклнечность).
Лавинный пробой, как правило, имеет микроплазменныйхарактер: ток течёт не по всей площади р - n -П., а локализован вотд. точках (микроплазмах), выявляемых по яркому свечению. С ростом токапробоя число микроплазм растёт вплоть до однородного покрытия ими всейплощади.
Если хотя бы одна сторона р - n -П. <легирована слабо или же р - n -П. имеет плавную структуру, лавинныйпробой наступает при напряжении, недостаточном для проявления заметнойтуннельной генерации. В резких переходах с сильным легированием обеих сторонтуннельная генерация начинает доминировать до наступления лавинного пробоя, <так что ему предшествует на обратной ветви ВАХ участок быстрого туннельногонарастания тока (рис. 4).
д) Фотогеперация, сторонняя инжекция. <Током р - n -П. можно управлять с помощью фотогенерации неравновесныхносителей в его окрестности. Ток j ф, обусловленный фотогенерацией(фототок), в отсутствие лавинного размножения аддитивно складывается сдр. составляющими тока, а при наличии лавинного размножения - с составляющимипервичного тока. При наличии фототока (кривая 5, рис. 4) ВАХ не проходитчерез точку j = 0, U= 0, возникает участок, на к-ром знак j не совпадает со знаком U (кривая 6, рис. 4). В этом режиме р - n -П. выступает в качестве фотоэлемента, преобразующегоэнергию излучения в электрич. энергию (см. также Солнечная батарея). Кроме режима фотоэлемента используется режим фотодиода, отвечающийобратной ветвп ВАХ.
Др. способ управления током р - n -П.- инжекция неосновных носителей в одну из образующих переход областей полупроводникас помощью др. р - п -П. или иного инжектирующего контакта. Этот способуправления током р - п -П. - коллектора путём ин-жекции р - п -П.- эмиттером лежит в основе работы транзисторов. Ток р - n -П. <можно также изменять разогревом носителей эл.-магн. излучением СВЧ-илиИК-диапазона.Способы получения р-n -П. Сплавные переходы получают, нанося на полупроводниковуюкристаллич. подложку "навеску" легкоплавкого металлич. сплава, в составк-рого входит необходимое легирующее вещество. При нагреве образуется областьжидкого расплава, состав к-рого определяется совместным плавлением навескии подложки. При остывании формируется рекристаллизац. область полупроводника, <обогащённая легирующими атомами. Если тип легирования этой области отличенот типа легирования подложки, то образуется резкий р - n -П., причёмего металлургич. граница х0 совпадает с границей рекристаллизац. <области. В сплавных переходах на этой поверхности разность изменяется скачком(резкий р - n -переход).
При вытягивании из расплава формированиеперехода происходит в процессе роста полупроводникового слитка путём дозированногоизменения состава легирующих примесей в расплаве. Диффузионные переходыполучают диффузией легирующих примесей из источников в газообразной, жидкойи твёрдой фазах. Имплантированные переходы образуются при ионной имплантации легирующих примесей.
Эпитаксиальные переходы получают методомэпитак-сиального выращивания или наращивания, в т. ч. методом молекулярно-лучевойэпитаксии, позволяющим пространственно наиболее тонко (с разрешающей способностьюдо 1 нм) регулировать закон изменения N Д(x) - Na(x). Частоприменяются комбиниров. способы: после вплавления, имплантации или эпитаксиальноговыращивания производится диффузионная доводка структуры.
При получении р - n -П. регулируетсяне только легирование р- и n -областей, но и структура всегопереходного слоя; в частности, получается необходимый градиент а = d(N Д- Na)/dx в точке металлургич. перехода х= х 0. В большинстве случаев применяются асимметричные р +- п- или п + - р -П., в к-рых легирование одной изобластей (+) намного сильнее другой.
Применения, р - n -П. обладает нелинейнойВАХ с большим коэф. выпрямления, на чём основано действие выпрямительных(полупроводниковых) диодов. За счёт изменения толщины обеднённого слояс изменением напряжения U он имеет управляемую нелинейную ёмкость(см. Варикап). Включённый в прямом направлении, он инжектирует носителииз одной своей области в другую. Инжектиров. носители могут управлять токомдр. р - n- П ., рекомбинировать с излучением света, превращая р- n -П. в электролюминесцентный источник излучения (см. Светоизлцчающийдиод), инерционно задерживаться в области инжекции при быстрых переключенияхнапряжения на р - n -П. Ток р - n- П . управляетсясветом или др. ионизирующими излучениями (см. Полупроводниковый детектор).
Свойства р - n -П. обусловливаютих применение в разл. приборах: выпрямительные, детекторные, смесительныедиоды (см. Диоды твердотельные); биполярные и униполярные транзисторы;туннельные диоды; лавинно-пролётные диоды (СВЧ-генераторы); фотодиоды, <лавинные фотодиоды, фототранзисторы; тиристоры, фототиристоры; фотоэлементы, <солнечные батареи; светодиоды, инжекц. лазеры; детекторы частиц и др. .- n -П. вытесняются Шоттки барьерами, изотипными гетеропереходами, <планарно-легированными барьерами.Лит.: Смит Р., Полупроводники, пер. <с англ., 2 изд., М., 1982; 3 и С. М., Физика полупроводниковых приборов, <кн. 1 - 2, пер. с англ., М., 1984; Бонч - Бруевич В. Л., Калашников С. <Г., Физика полупроводников, М., 1977.
3. С. Грибников.
Физическая энциклопедия. В 5-ти томах. — М.: Советская энциклопедия. Главный редактор А. М. Прохоров. 1988.
.
