- ИОННАЯ ИМПЛАНТАЦИЯ
- ИОННАЯ ИМПЛАНТАЦИЯ
-
(ионное внедрение, ионное легирование) - введение примесных атомов в твёрдое тело бомбардировкой его поверхности ускореннымиионами. При ионной бомбардировке мишени наряду с процессами распыления поверхности, ионно-ионной эмиссии, образования радиационных дефектов и др. происходит проникновение ионов в глубь мишени. Внедрение ионов становится существенным при энергии ионов E>1 кэВ. Движущиеся частицы в результате многократных столкновений постепенно теряют энергию, рассеиваются и в конечном итоге либо отражаются назад, либо останавливаются, распределяясь по глубине. Энергетич. потери обусловлены как взаимодействием с электронами мишени (неупругие столкновения), так и парными ядерными (упругими) столкновениями, при к-рых энергия передаётся атомам мишени в целом и резко изменяется направление движения частицы. <При высоких энергиях и малых прицельных параметрах ядра сталкивающихся частиц сближаются на расстояния, меньшие радиусов электронных орбит, и их взаимодействие описывается кулоновским потенциалом. При низких энергиях существенно экранирование ядер электронами и потенциал взаимодействия:

где Z1, Z2 - ат. номера иона и атома мишени, r - расстояние между ядрами, а - параметр экранирования, Ф(r/а) - ф-ция экранирования. <В нек-ром приближении можно раздельно рассматривать взаимодействие движущегося иона с электронами (свободными и на внеш. оболочках атомов) и взаимодействие между ядрами иона и атома мишени, считая оба механизма потерь аддитивными, а среду однородной и изотропной (теория Линдхарда - Шарфа - Шиотта, ЛШШ). Если ввести приведённую безразмерную энергию ионов
и приведённый безразмерный пробег
где E' и R - энергия и пробег иона; M1, M2 - массы (в а. е. м.) бомбардирующего иона (1) и атомов мишени (2); n0 - концентрация атомов мишени, то удельные потери энергии
В теории ЛШШ Ф(r/а) - ф-ция Томаса -Ферми с параметром экранирования а=0,885
(см. Плазма твёрдых тел). Удельные потери в упругих столкновениях (dE/dr)n проходят через максимум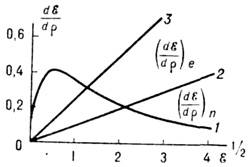
Рис. 1. Зависимости удельных потерь энергии dE/dpот E1/2 по теории ЛШШ: 1 - упругие потери; 2,3 - неупругие потери энергии для К=0,1 и К= 0,25.и убывают с ростом E(кривая 1, рис. 1). Удельные потери в неупругих столкновениях

Для большинства комбинаций ион - атом мишени К , лежит в интервале 0,1-0,25 (кривые 2 и 3, рис. 1). При очень больших скоростях v( ) теория ЛШШ неприменима, а при
) теория ЛШШ неприменима, а при  ион движется в мишени как голое ядро и удельные потери энергии убывают с дальнейшим её ростом. <Теория ЛШШ даёт совпадение с экспериментом, как правило, с точностью не хуже 30%. Обнаруженные осцилляции электронных потерь в зависимости от Z1 и Z2 описываются более совершенной теорией, использующей волновые ф-ции Хартри - Фока - Слэтера.
ион движется в мишени как голое ядро и удельные потери энергии убывают с дальнейшим её ростом. <Теория ЛШШ даёт совпадение с экспериментом, как правило, с точностью не хуже 30%. Обнаруженные осцилляции электронных потерь в зависимости от Z1 и Z2 описываются более совершенной теорией, использующей волновые ф-ции Хартри - Фока - Слэтера.
Траектория иона представляет собой сложную ломаную линию, состоящую из отрезков пути между элементарными актами рассеяния на большие углы. В первом приближении траекторный пробег для частицы с нач. энергией E0 равен:
Важными характеристиками процесса И. и. являются т. н. проективный пробег иона R пр - проекция траекторного пробега на направление первонач. движения частицы, а также распределение имплантированных атомов по R пр, т. е. по глубине х(при бомбардировке по нормали к поверхности мишени). Распределение по x частиц, имплантированных в аморфную мишень, характеризуется ср. пробегом , среднеквадратичным разбросом пробегов
, среднеквадратичным разбросом пробегов  и параметром Sk, определяющим асимметрию распределения Пирсона (рис. 2).Величины
и параметром Sk, определяющим асимметрию распределения Пирсона (рис. 2).Величины  , DR пр и Sk зависят от М1, М2 и E0 (рис. 3). При Sk=0 распределение Пирсона переходит в гауссовское. При И. и. в монокристаллы распределение внедрённых частиц по глубине может видоизменяться из-за каналирования заряженных частиц. Изменяя в процессе И. и. энергию ионов, можно получить распределение внедрённой примеси по глубине желаемой формы.
, DR пр и Sk зависят от М1, М2 и E0 (рис. 3). При Sk=0 распределение Пирсона переходит в гауссовское. При И. и. в монокристаллы распределение внедрённых частиц по глубине может видоизменяться из-за каналирования заряженных частиц. Изменяя в процессе И. и. энергию ионов, можно получить распределение внедрённой примеси по глубине желаемой формы.
Рис. 3. Зависимости параметров распределения (a),
(a),  (б), Sk (в) ионов В, Р, As в Si от начальной энергии ионов E0.Полное число атомов примеси N п, к-рое может быть имплантировано в твердотельную мишень через единицу поверхности, ограничивается распылением, если коэф. распыления S (число атомов мишени, выбиваемых одним ионом) больше доли внедряющихся частицa=l-k (k- коэф. отражения). В пренебрежении диффузией
(б), Sk (в) ионов В, Р, As в Si от начальной энергии ионов E0.Полное число атомов примеси N п, к-рое может быть имплантировано в твердотельную мишень через единицу поверхности, ограничивается распылением, если коэф. распыления S (число атомов мишени, выбиваемых одним ионом) больше доли внедряющихся частицa=l-k (k- коэф. отражения). В пренебрежении диффузией 
где nS=an0/S - концентрация примеси у поверхности в установившемся режиме. Ф-ла (7) получена в предположении постоянства E0 в процессе И. и. и равенства вероятностей распыления атомов матрицы и имплантированных частиц. Если S<a, концентрация имплантированных атомов будет монотонно расти с увеличением дозы ионов. <Наиб, широко И. п. применяется для легирования полупроводников с целью создания р -n-переходов, гетеропереходов, низкоомных контактов. И. и. позволяет вводить примеси при низкой темп-ре, в том числе примеси с малым коэф. диффузии, создавать пересыщенные твёрдые растворы. И. и. обеспечивает точную дозировку вводимой примеси, высокую чистоту (сепарация пучка ионов по массам), локальность, а также возможность управления процессом с помощью электрич. и магн. полей. Для устранения образующихся при И. и. радиац. дефектов и перевода внедрённых атомов в регулярные положения используют высокотемпературный прогрев. Для создания р -n-переходов не требуется больших доз облучения. Так, при бомбардировке Si ионами Р + с энергией E0=50 кэВ, =60 нм,
=60 нм,  =26 нм, и уже при дозе 1015 см -2 ср. концентрация примеси в имплантированном слое толщиной 4
=26 нм, и уже при дозе 1015 см -2 ср. концентрация примеси в имплантированном слое толщиной 4  достигает 1020 см -3, т. е. практически предельной концентрации, используемой в технологии. <И. и. в металлы применяют с целью повышения их твёрдости, износоустойчивости, коррозионной стойкости, создания катализаторов, изменения коэф. трения и т. п. Для этого требуются дозы ~1017 -1018 ионов на см 2, при к-рых уже заметно распыление приповерхностного слоя. При больших дозах, когда концентрация внедрённой примеси сравнима с n0, возможно образование новых соединений (ионный синтез).Ионная бомбардировка позволяет вводить примесь не только из пучка, но и из плёнки, предварительно нанесённой на поверхность мишени (имплантация атомов отдачи и ионное перемешивание).Бомбардировка ионами с энергией 10-200 эВ, когда SЪ1, а
достигает 1020 см -3, т. е. практически предельной концентрации, используемой в технологии. <И. и. в металлы применяют с целью повышения их твёрдости, износоустойчивости, коррозионной стойкости, создания катализаторов, изменения коэф. трения и т. п. Для этого требуются дозы ~1017 -1018 ионов на см 2, при к-рых уже заметно распыление приповерхностного слоя. При больших дозах, когда концентрация внедрённой примеси сравнима с n0, возможно образование новых соединений (ионный синтез).Ионная бомбардировка позволяет вводить примесь не только из пучка, но и из плёнки, предварительно нанесённой на поверхность мишени (имплантация атомов отдачи и ионное перемешивание).Бомбардировка ионами с энергией 10-200 эВ, когда SЪ1, а  ~0,1-1 нм, сопровождается наращиванием имплантируемого материала. Плёнки, полученные ионным осаждением, имеют высокую плотность и хорошую адгезию к подложке. Лит.: Мейер Д ж., Эриксон Л., Дэвис Д ж., Ионное легирование полупроводников, пер. с англ., М., 1973; Зорин Е. И., Павлов П. В., Тетельбаум Д. И., Ионное легирование полупроводников, М., 1975; Ионная имплантация в полупроводники и другие материалы. Сб. ст., пер. c англ., под ред. В. <С. <Вавилова, М., 1980; Аброян И. А., Андронов А. Н., Титов А. И., Физические основы электронной и ионной технологии, М., 1984. И. А. Аброян.
~0,1-1 нм, сопровождается наращиванием имплантируемого материала. Плёнки, полученные ионным осаждением, имеют высокую плотность и хорошую адгезию к подложке. Лит.: Мейер Д ж., Эриксон Л., Дэвис Д ж., Ионное легирование полупроводников, пер. с англ., М., 1973; Зорин Е. И., Павлов П. В., Тетельбаум Д. И., Ионное легирование полупроводников, М., 1975; Ионная имплантация в полупроводники и другие материалы. Сб. ст., пер. c англ., под ред. В. <С. <Вавилова, М., 1980; Аброян И. А., Андронов А. Н., Титов А. И., Физические основы электронной и ионной технологии, М., 1984. И. А. Аброян.
Физическая энциклопедия. В 5-ти томах. — М.: Советская энциклопедия. Главный редактор А. М. Прохоров. 1988.
.
