- ЭЛЕКТРОННАЯ МИКРОСКОПИЯ
- ЭЛЕКТРОННАЯ МИКРОСКОПИЯ
-
совокупность методов исследования с помощью электронных микроскопов (МЭ) микроструктур тел (вплоть до атомно-молекулярного уровня), их локального состава и локализованных на поверхностях или в микрообъёмах тел электрич. и магн. полей («микрополей»). Э. м. включает также усовершенствование и разработку новых МЭ и др. корпускулярных микроскопов (напр., протонного микроскопа) и приставок к ним; разработку методик подготовки образцов, исследуемых в МЭ; изучение механизмов формирования электронно-оптич. изображений; разработку способов анализа получаемой информации.Объекты исследования в Э. м.— обычно тв. тела. В просвечивающих МЭ (ПЭМ) эл-ны с энергиями от 1 кэВ до 5 МэВ проходят сквозь объект, поэтому изучаются образцы в виде тонких плёнок, фольги (рис. 1), срезов и т. <п. толщиной от 1 нм до 10 мкм (от 10 A до 105 A). Микрокристаллы, порошки, аэрозоли и т. п. можно изучать, нанеся их предварительно на подложку: тонкую плёнку для исследования в ПЭМ или массивную подложку для исследования в растровых МЭ (РЭМ). Поверхностную и приповерхностную структуру массивных тел толщиной существенно больше 1 мкм исследуют с помощью РЭМ (рис. 2), отражательных, зеркальных МЭ, ионных проекторов и электронных проекторов. Поверхностная геом. структура массивных тел изучается также и методом реплик: с поверхности такого тела снимается отпечаток в виде тонкой плёнки углерода, коллодия, формвара и т. п., повторяющий рельеф поверхности и рассматриваемый в ПЭМ. Обычно предварительно на реплику в вакууме напыляется под скользящим (малым к поверхности) углом слой сильно рассеивающего эл-ны тяжёлого металла (напр., Pt), оттеняющий выступы и впадины геом. рельефа — т. н. метод декорирования. Этот метод позволяет исследовать не только геом. структуры поверхностей, но и микрополя, обусловленные дислокациями (рис. 3), скоплениями точечных дефектов (см. ДЕФЕКТЫ В КРИСТАЛЛАХ), ступенями роста крист. граней, доменной структурой (см. ДОМЕНЫ) и т. д. В этом случае на поверхность образца вначале напыляется очень тонкий слой декорирующих ч-ц (атомы Au, Pt, молекулы полупроводников или диэлектриков), осаждающихся преим. на участках сосредоточения микрополей, а затем снимается реплика с включениями декорирующих ч-ц. Рис. 1. Полученное в просвечивающем электронном микроскопе изображение сетки дислокаций на границах зёрен в тонкой молибденовой фольге, деформированной при высокотемпературном нагреве.
Рис. 1. Полученное в просвечивающем электронном микроскопе изображение сетки дислокаций на границах зёрен в тонкой молибденовой фольге, деформированной при высокотемпературном нагреве. Рис. 2. Изображение предварительно отполированной, а затем подвергнутой ионной бомбардировке поверхности монокристалла меди. Снято в растровом электронном микроскопе. Увеличение 3000.
Рис. 2. Изображение предварительно отполированной, а затем подвергнутой ионной бомбардировке поверхности монокристалла меди. Снято в растровом электронном микроскопе. Увеличение 3000. Рис. 3. Винтовые дислокации на поверхности кристалла NaCl, подвергнутого термич. травлению при температуре 773 К. Изображение получено методом декорирования.С помощью газовых микрокамер — приставок к ПЭМ или РЭМ — можно изучать жидкие и газообразные объекты, неустойчивые к воздействию высокого вакуума, в т. ч. влажные биол. препараты. Радиационное воздействие облучающего электронного пучка довольно велико, поэтому при исследовании биол., полупроводниковых, полимерных и т. п. объектов необходимо тщательно выбирать режим работы МЭ, обеспечивающий минимальную дозу облучения.Наряду с исследованием статических, не меняющихся во времени объектов Э. м. даёт возможность изучать разл. процессы в динамике их развития: рост плёнок, деформацию кристаллов под действием переменной нагрузки, изменение структуры под влиянием электронного или ионного облучения и т. д. Благодаря малой инерционности эл-нов можно исследовать периодические во времени процессы, напр. перемагничивание тонких магнитных плёнок, изменение поляризации сегнетоэлектриков, распространение УЗ волн и т. д. Эти исследования проводят методами стробоскопической Э. м. (рис. 4): образец «освещается» электронным пучком не непрерывно, а импульсно, синхронно с подачей импульсного напряжения на образец, что обеспечивает фиксацию на экране прибора определённой фазы процесса точно так же, как это происходит в светооптич. стробоскопических приборах. Предельное временное разрешение при этом может в принципе составлять ок. 10-15 с для ПЭМ (пока практически реализовано разрешение =10-12 с для ПЭМ и РЭМ).Аморфные и квазиаморфные тела, размеры ч-ц к-рых меньше разрешаемого в МЭ расстояния, рассеивают эл-ны диффузно. Для их исследования используются простейшие методы амплитудной Э. м. Напр., в ПЭМ контраст изображения, т. е. перепад яркостей изображения соседних участков объекта, в первом приближении пропорционален перепаду толщин этих участков. Для расчёта контраста изображений крист. тел и решения обратной задачи — расчёта структуры объекта по наблюдаемому изображению — привлекаются методы фазовой Э. м.: решается задача о дифракции электронов (см. ДИФРАКЦИЯ МИКРОЧАСТИЦ, ЭЛЕКТРОНОГРАФИЯ) на крист. решётке. При этом дополнительно учитываются неупругие вз-ствия эл-нов с объектом: рассеяние на плазмонах, фононах и т. п.
Рис. 3. Винтовые дислокации на поверхности кристалла NaCl, подвергнутого термич. травлению при температуре 773 К. Изображение получено методом декорирования.С помощью газовых микрокамер — приставок к ПЭМ или РЭМ — можно изучать жидкие и газообразные объекты, неустойчивые к воздействию высокого вакуума, в т. ч. влажные биол. препараты. Радиационное воздействие облучающего электронного пучка довольно велико, поэтому при исследовании биол., полупроводниковых, полимерных и т. п. объектов необходимо тщательно выбирать режим работы МЭ, обеспечивающий минимальную дозу облучения.Наряду с исследованием статических, не меняющихся во времени объектов Э. м. даёт возможность изучать разл. процессы в динамике их развития: рост плёнок, деформацию кристаллов под действием переменной нагрузки, изменение структуры под влиянием электронного или ионного облучения и т. д. Благодаря малой инерционности эл-нов можно исследовать периодические во времени процессы, напр. перемагничивание тонких магнитных плёнок, изменение поляризации сегнетоэлектриков, распространение УЗ волн и т. д. Эти исследования проводят методами стробоскопической Э. м. (рис. 4): образец «освещается» электронным пучком не непрерывно, а импульсно, синхронно с подачей импульсного напряжения на образец, что обеспечивает фиксацию на экране прибора определённой фазы процесса точно так же, как это происходит в светооптич. стробоскопических приборах. Предельное временное разрешение при этом может в принципе составлять ок. 10-15 с для ПЭМ (пока практически реализовано разрешение =10-12 с для ПЭМ и РЭМ).Аморфные и квазиаморфные тела, размеры ч-ц к-рых меньше разрешаемого в МЭ расстояния, рассеивают эл-ны диффузно. Для их исследования используются простейшие методы амплитудной Э. м. Напр., в ПЭМ контраст изображения, т. е. перепад яркостей изображения соседних участков объекта, в первом приближении пропорционален перепаду толщин этих участков. Для расчёта контраста изображений крист. тел и решения обратной задачи — расчёта структуры объекта по наблюдаемому изображению — привлекаются методы фазовой Э. м.: решается задача о дифракции электронов (см. ДИФРАКЦИЯ МИКРОЧАСТИЦ, ЭЛЕКТРОНОГРАФИЯ) на крист. решётке. При этом дополнительно учитываются неупругие вз-ствия эл-нов с объектом: рассеяние на плазмонах, фононах и т. п.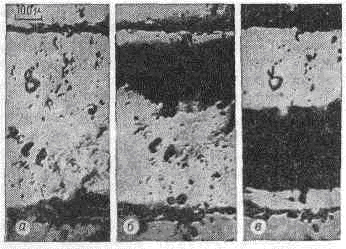 Рис. 4. Изображения поверхности кремниевого ПП диода, полученные в стробоскопич. эмиссионном электронном микроскопе: а — напряжение на диоде отсутствует; б — на диод подано запирающее напряжение 40 В, тёмная область — падение напряжения на p — n-переходе; в — кратковременное (менее 40 нс) прямое падение напряжения (широкая тёмная область) на базе диода при переключении его в состояние, при к-ром он «отперт».
Рис. 4. Изображения поверхности кремниевого ПП диода, полученные в стробоскопич. эмиссионном электронном микроскопе: а — напряжение на диоде отсутствует; б — на диод подано запирающее напряжение 40 В, тёмная область — падение напряжения на p — n-переходе; в — кратковременное (менее 40 нс) прямое падение напряжения (широкая тёмная область) на базе диода при переключении его в состояние, при к-ром он «отперт». Рис. 5. Изображение доменной структуры тонкой, однородной по толщине пермаллоевой плёнки. Снято в просвечивающем электронном микроскопе при дефокусировке изображения (метод лоренцевой электронной микроскопии). Светлые и тёмные узкие полосы — границы доменов. Видна «рябь» намагниченности, возникающая вследствие малых изменении направлений векторов намагниченности (отмечены стрелками) внутри доменов.В ПЭМ и растровых ПЭМ (ПРЭМ) высокого разрешения получают изображения отд. молекул или атомов тяжёлых элементов; пользуясь методами фазовой Э. м., восстанавливают по изображениям трёхмерную структуру кристаллов и биол. макромолекул. Для решения подобных задач применяют, в частности, методы голографии, а расчёты производят на ЭВМ.Разновидность фазовой Э. м.— интерференционная Э. м., аналогичная оптич. интерферометрии (см. ИНТЕРФЕРОМЕТР): электронный пучок расщепляется с помощью электронных призм, и в одном из плеч интерферометра устанавливается образец, изменяющий фазу проходящей сквозь него электронной волны. Этим методом можно измерить, напр., внутр. электрич. потенциал образца.С помощью т. н. лоренцовой Э. м., в к-рой изучают явления, обусловленные Лоренца силой, исследуют внутр. магн. и электрич. поля или внеш. поля рассеяния, напр. поля магн. доменов в тонких плёнках (рис. 5), сегнетоэлектрич. доменов, поля головок для магн. записи информации и т. п.Состав объектов исследуется методами микродифракции, т. е. электронографии локальных участков объекта; методами рентг. и катодолюминесцентного локального спектр. микроанализа (см. КАТОДОЛЮМИНЕСЦЕНЦИЯ, СПЕКТРАЛЬНЫЙ АНАЛИЗ РЕНТГЕНОВСКИЙ); регистрируется рентг. излучение на характеристических частотах или Катодолюминесценция, возникающие при бомбардировке образца сфокусированным пучком эл-нов (диаметр электронного «зонда» менее 1 мкм).
Рис. 5. Изображение доменной структуры тонкой, однородной по толщине пермаллоевой плёнки. Снято в просвечивающем электронном микроскопе при дефокусировке изображения (метод лоренцевой электронной микроскопии). Светлые и тёмные узкие полосы — границы доменов. Видна «рябь» намагниченности, возникающая вследствие малых изменении направлений векторов намагниченности (отмечены стрелками) внутри доменов.В ПЭМ и растровых ПЭМ (ПРЭМ) высокого разрешения получают изображения отд. молекул или атомов тяжёлых элементов; пользуясь методами фазовой Э. м., восстанавливают по изображениям трёхмерную структуру кристаллов и биол. макромолекул. Для решения подобных задач применяют, в частности, методы голографии, а расчёты производят на ЭВМ.Разновидность фазовой Э. м.— интерференционная Э. м., аналогичная оптич. интерферометрии (см. ИНТЕРФЕРОМЕТР): электронный пучок расщепляется с помощью электронных призм, и в одном из плеч интерферометра устанавливается образец, изменяющий фазу проходящей сквозь него электронной волны. Этим методом можно измерить, напр., внутр. электрич. потенциал образца.С помощью т. н. лоренцовой Э. м., в к-рой изучают явления, обусловленные Лоренца силой, исследуют внутр. магн. и электрич. поля или внеш. поля рассеяния, напр. поля магн. доменов в тонких плёнках (рис. 5), сегнетоэлектрич. доменов, поля головок для магн. записи информации и т. п.Состав объектов исследуется методами микродифракции, т. е. электронографии локальных участков объекта; методами рентг. и катодолюминесцентного локального спектр. микроанализа (см. КАТОДОЛЮМИНЕСЦЕНЦИЯ, СПЕКТРАЛЬНЫЙ АНАЛИЗ РЕНТГЕНОВСКИЙ); регистрируется рентг. излучение на характеристических частотах или Катодолюминесценция, возникающие при бомбардировке образца сфокусированным пучком эл-нов (диаметр электронного «зонда» менее 1 мкм). Рис. 6. Изображение линий равной напряжённости поля (от 25 до 150 Гс через 25 Гс) над зазором магн. головки (ширина зазора 26=2 мкм) для магн. записи информации. Получено в растровом электронном микроскопе со спец. приставкой.Кроме того, изучаются энергетич. спектры вторичных эл-нов, выбитых первичным электронным пучком с поверхности или из объёма образца (см. ОЖЕ-СПЕКТРОСКОНИЯ).Интенсивно разрабатываются методы количеств. Э. м.— точного измерения разл. параметров образца или исследуемого процесса, напр, измерение локальных электрич. потенциалов, магн. полей (рис. 6), микрогеометрии поверхностного рельефа и т. д. МЭ используются и в технологич. целях (напр., для изготовления микросхем методом электронолитографии).
Рис. 6. Изображение линий равной напряжённости поля (от 25 до 150 Гс через 25 Гс) над зазором магн. головки (ширина зазора 26=2 мкм) для магн. записи информации. Получено в растровом электронном микроскопе со спец. приставкой.Кроме того, изучаются энергетич. спектры вторичных эл-нов, выбитых первичным электронным пучком с поверхности или из объёма образца (см. ОЖЕ-СПЕКТРОСКОНИЯ).Интенсивно разрабатываются методы количеств. Э. м.— точного измерения разл. параметров образца или исследуемого процесса, напр, измерение локальных электрич. потенциалов, магн. полей (рис. 6), микрогеометрии поверхностного рельефа и т. д. МЭ используются и в технологич. целях (напр., для изготовления микросхем методом электронолитографии).
Физический энциклопедический словарь. — М.: Советская энциклопедия. Главный редактор А. М. Прохоров. 1983.
- ЭЛЕКТРОННАЯ МИКРОСКОПИЯ
-
-совокупность методов исследования с помощью электронных микроскопов микроструктур тел (вплоть до атомно-молекулярного уровня), их локального состава и локализованных на поверхностях или в микрообъёмах тел электрич. и магн. полей ("микрополей"). Как самостоятельное научное направление Э. м. включает: усовершенствование и разработку новых электронных и др. корпускулярных микроскопов (напр., протонного микроскопа) и приставок к ним; разработку методик препарирования образцов, исследуемых в электронных микроскопах; изучение механизмов формирования электронно-оптич. изображений; разработку способов анализа разнообразной информации, получаемой с помощью электронных микроскопов.
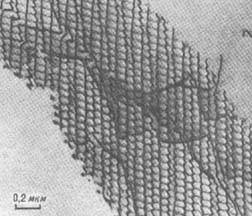
Рис. 1. Полученное в просвечивающем электронном микро скопе изображение сетки дислокаций на границах зёрен в тонкой молибденовой фольге, деформированной при высо котемпературном нагреве.
Объекты исследования в Э. м.- обычно твёрдые тела. В просвечивающих электронных микроскопах (ПЭМ), в к-рых электроны с энергиями от 1 кэВ до 5 МэВ проходят сквозь объект, изучаются образцы в виде тонких плёнок, фольги (рис. 1), срезов и т. п. толщиной от 1 нм до 10 мкм (от 10
 до 105
до 105  ). Порошки, микрокристаллы, аэрозоли и т. п. можно изучать, нанеся их предварительно на подложку- тонкую плёнку для исследования в ПЭМ или массивную подложку для исследования в растровых электронных микроскопах (РЭМ). Поверхностную и припо-верхностную структуру массивных тел толщиной существенно больше 1 мкм исследуют с помощью РЭМ (рис. 2), отражательных и зеркальных, а также ионных проекторов и электронных проекторов. Поверхностная геом. структура массивных тел изучается также и методом реплик: с поверхности такого тела снимается реплика-отпечаток в виде тонкой плёнки углерода, коллодия, формвара и т. п., повторяющая рельеф поверхности, и рассматривается в ПЭМ. Обычно предварительно на реплику в вакууме напыляется под скользящим углом слой сильно рассеивающего электроны тяжёлого металла (напр., Pt), оттеняющего выступы и впадины геом. рельефа. Метод т. н. декорирования позволяет исследовать не только геом. структуру поверхностей, но и электрическую, т. е. микро-поля, обусловленные наличием дислокаций (рис. 3), скоплений точечных дефектов (см. Дефекты), ступенями роста кристаллич. граней, доменной структурой (см. Домены )и т. д. При таком методе исследования на поверхность образца вначале напыляется очень тонкий слой декорирующих частиц (атомы тяжёлого металла с большим коэф. поверхностной диффузии, молекулы полупроводников или диэлектриков), осаждающихся преим. на участках сосредоточения микрополей, а затем снимается реплика с включениями декорирующих микрополя частиц.
). Порошки, микрокристаллы, аэрозоли и т. п. можно изучать, нанеся их предварительно на подложку- тонкую плёнку для исследования в ПЭМ или массивную подложку для исследования в растровых электронных микроскопах (РЭМ). Поверхностную и припо-верхностную структуру массивных тел толщиной существенно больше 1 мкм исследуют с помощью РЭМ (рис. 2), отражательных и зеркальных, а также ионных проекторов и электронных проекторов. Поверхностная геом. структура массивных тел изучается также и методом реплик: с поверхности такого тела снимается реплика-отпечаток в виде тонкой плёнки углерода, коллодия, формвара и т. п., повторяющая рельеф поверхности, и рассматривается в ПЭМ. Обычно предварительно на реплику в вакууме напыляется под скользящим углом слой сильно рассеивающего электроны тяжёлого металла (напр., Pt), оттеняющего выступы и впадины геом. рельефа. Метод т. н. декорирования позволяет исследовать не только геом. структуру поверхностей, но и электрическую, т. е. микро-поля, обусловленные наличием дислокаций (рис. 3), скоплений точечных дефектов (см. Дефекты), ступенями роста кристаллич. граней, доменной структурой (см. Домены )и т. д. При таком методе исследования на поверхность образца вначале напыляется очень тонкий слой декорирующих частиц (атомы тяжёлого металла с большим коэф. поверхностной диффузии, молекулы полупроводников или диэлектриков), осаждающихся преим. на участках сосредоточения микрополей, а затем снимается реплика с включениями декорирующих микрополя частиц.
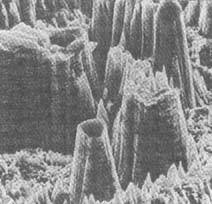
Рис. 2. Изображение предварительно отполированной, а затем подвергнутой ионной бомбардировке поверхности монокристалла меди. Снято в растровом электрон ном микроскопе: увеличение 3000.

Рис. 3. Винтовые дислокации на поверхности кристалла NaCl, подвергнутого термическому травлению при темпе ратуре 773 К. Изображение получено методом декориро вания.
С помощью газовых микрокамер - приставок к ПЭМ или РЭМ - можно изучать жидкие и газообразные объекты, неустойчивые к воздействию высокого вакуума, в т. ч. влажные биол. препараты. Радиац. воздействие облучающего электронного пучка довольно велико, поэтому при исследовании биол., полупроводниковых, полимерных и т. п. объектов необходимо тщательно выбирать режим работы электронного микроскопа, обеспечивающий мин. дозу облучения.
Наряду с исследованиями статических, не меняющихся во времени объектов, Э. м. даёт возможность изучать разл. процессы в динамике их развития: рост плёнок, деформацию кристаллов под действием переменной нагрузки, изменение структуры под влиянием электронного или ионного облучения и т. д. Благодаря малой инерционности электронов можно исследовать периодические во времени процессы, напр. перемагничивание тонких магнитных плёнок, изменение поляризации сегнетоэлектриков, распространение УЗ-волн и т. д. Эти исследования проводят методами стробоскопической Э. м. (рис. 4): образец "освещается" электронным пучком не непрерывно, а им
пульсами, синхронными с подачей импульсного напряжения на образец, что обеспечивает фиксацию на экране прибора определ. фазы процесса точно так же, как это происходит в светооптич. стробоскопических приборах. Предельное временное разрешение при этом может, в принципе, составлять ок. 10-15 с для ПЭМ (реализовано разрешение лучшее 10-12 с для ПЭМ и РЭМ).
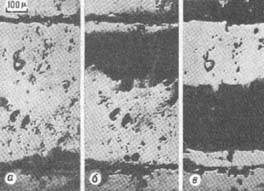
Рис. 4. Изображения поверхности кремниевого полупроводникового диода, полученные в стробоскопическом эмиссионном электронном микроскопе: а - напряжение на диоде отсутствует; б- на диод подано запирающее напряжение 40 В, тёмная область - падение напряжения на р-n -переходе; в- кратковременное (менее 40 нc) прямое падение напряжения (широкая тёмная область) на базе диода при переключении его в состояние, при котором он "отперт".
Аморфные и квазиаморфные тела, размеры частиц к-рых меньше разрешаемого в электронном микроскопе расстояния, рассеивают электроны диффузно. Для их исследования используются простейшие методы амплитудной Э. м. Напр., в ПЭМ контраст изображения, т. е. перепад яркостей изображения соседних участков объекта, в первом приближении пропорционален перепаду толщин этих участков. Для расчёта контраста изображений кристаллич. тел и решения обратной задачи - расчёта структуры объекта по наблюдаемому изображению - привлекаются методы фазовой Э. м.: решается задача о дифракции электронов на кристаллич. решётке. При этом дополнительно учитываются неупругие взаимодействия электронов с объектом: рассеяние на плазмонах, фононах и т. п. В ПЭМ и растровых ПЭМ (ПРЭМ) высокого разрешения получают изображения отд. молекул или атомов тяжёлых элементов; пользуясь методами фазовой Э. м., восстанавливают по изображениям трёхмерную структуру кристаллов и биол. макромолекул. Для решения подобных задач применяют, в частности, методы голографии, а расчёты производят на ЭВМ.
Разновидность фазовой Э. м.- и н т е р ф е р е н ц и о нн а я Э. м., аналогичная оптич. интерферометрии: электронный пучок расщепляется с помощью электронных призм, в одном из плеч интерферометра устанавливается образец, изменяющий фазу проходящей сквозь него электронной волны. Этим методом можно измерить, напр., внутр. электрич. потенциал образца.
С помощью т. н. л о р е н ц е в о й Э. м., в к-рой изучают явления, обусловленные Лоренца силой, исследуют внутр. магн. и электрич. поля или внеш. поля рассеяния, напр. поля магн. доменов в тонких плёнках (рис. 5), сегнетоэлек-трич. доменов, поля головок для магн. записи информации и т. п.

Рис. 5. Изображение доменной структуры тонкой одно родной по толщине пермаллоевой плёнки. Снято в просве чивающем электронном микроскопе при дефокусировке изображения (метод лоренцевой электронной микроско пии). Светлые и тёмные узкие полосы- границы доме нов. Видна "рябь" намагниченности, возникающая вследствие малых изменений направлений векторов намагниченности (отмечены стрелками) внутри доменов.
Состав объектов исследуется методами микродифракции, т. е. электронографии локальных участков объекта, методами рентг. и катодолюминесцентного локального спектрального микроанализа (см. Рентгеноспектральный анализ): регистрируются рентг. излучение на характеристических частотах или катодолюминесценция, возникающие при бомбардировке образца сфокусированным пучком электронов (диаметр электронного "зонда" менее 1 мкм). Кроме того, изучаются энергетич. спектры вторичных электронов, выбитых первичным электронным пучком с поверхности или из объёма образца (см. Оже-спектро-скопия).
Интенсивно разрабатываются методы количественной Э. м.- точного измерения разл. параметров образца или исследуемого процесса, напрю измерение локальных элек-трич. потенциалов и магн. полей (рис. 6), микрогеометрии поверхностного рельефа и т. д. Электронные микроскопы используют и в технол. целях (напр., для изготовления микросхем методом электронолитографии).

Рис. 6. Изображение линий равной напряжённости поля (от 25 до 150 Гс через 25 Гс) над зазором магнитной го ловки (ширина зазора 28 = 2 мкм) для магнитной записи информации. Получено в растровом электронном микро скопе со специальной приставкой.
Развиваются также методы Э. м. с использованием туннельного тока (см. Сканирующий туннельный микроскоп).
Лит.: Стоянова И. Г., Анаскин И. Ф., Физические основы методов просвечивающей электронной микроскопии, М., 1972; Утевский Л. М., Дифракционная электронная микроскопия в металловедении, М., 1973; Хокс П., Электронная оптика и электронная микроскопия, пер. с англ., М., 1974; Практическая растровая электронная микроскопия, под ред. Дж. Гоулдстейна и X. Яковица, пер. с англ., М., 1978. А. Е. Лукьянов.
Физическая энциклопедия. В 5-ти томах. — М.: Советская энциклопедия. Главный редактор А. М. Прохоров. 1988.
.
